Amkor(安靠科技)表示,由英特尔(Intel)主导、作为CoWoS封装技术替代方案的玻璃基板,将在3年内实现商业化。
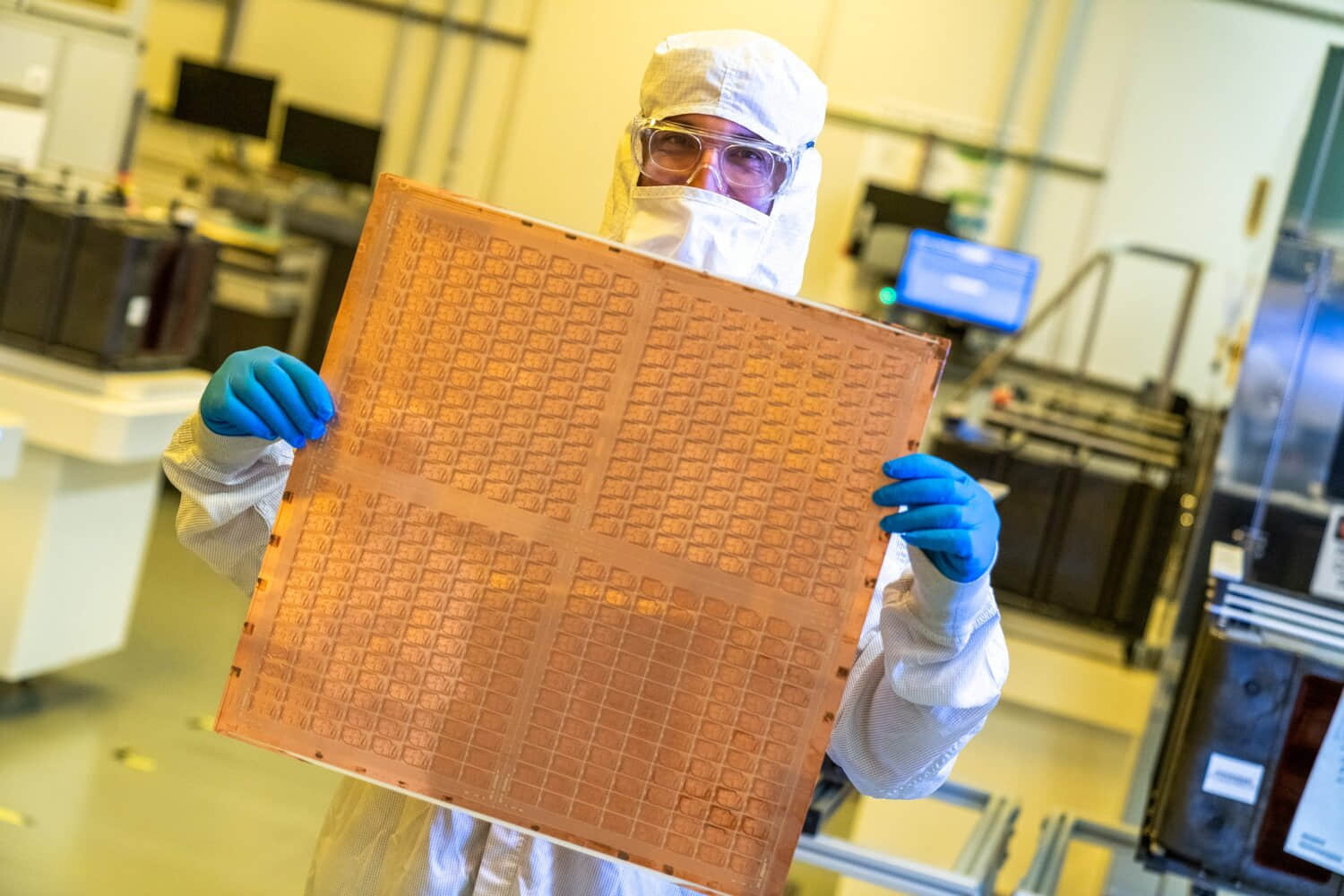
先进封装是任何大型晶圆代工业务的关键,因为芯片正变得越来越复杂,以满足日益增长的算力和内存需求。
台积电(TSMC)凭借其CoWoS 2.5D技术,是全球最重要的先进封装供应商。当前的芯片需求包括将HBM和逻辑芯片集成在单个封装中,并且HBM芯片的数量正在急剧增加。最近,OpenAI展示了如何利用类似EMIB的解决方案来突破当前CoWoS的限制。
以台积电(TSMC)为代表的半导体制造商正通过引入新的CoWoS芯片解决方案来扩展芯片能力。其中,2029年的设计方案将实现超过14个光罩尺寸的解决方案,提供24个HBM封装。此外,还有更先进的解决方案,如SoW-X,其规模将扩展到超过40个光罩尺寸和超过60个HBM封装。这将大幅提升下一代芯片的计算输出,但此类解决方案也存在一些问题。
主要问题在于复杂性和成本。随着设计规模不断攀升,芯片设计变得愈发困难,还会引入严重的热应力和机械应力,可能导致翘曲。此外,基于RDL的工艺也会增加芯片的生产时间,甚至超过一个月。
这导致半导体生态系统在性能、基板、热管理、连接技术和数据传输结构等方面出现瓶颈。为了克服这些挑战,玻璃基板技术被视为一种可行的替代方案。
在韩国首尔举行的The Elec(韩国电子时报)大会上,Amkor(安靠科技)技术团队负责人Yoo Dong-soo(刘东秀)表示,与传统有机基板相比,玻璃基板具有更优异的热稳定性和抗变形特性。
刘东秀表示:“过去,人们对玻璃基板能否承受封装过程中的应力存在疑问,但技术稳定性正在得到保障。我们预计它们将在三年内实现商业化。”
刘东秀:Amkor(安靠科技)技术团队负责人(来源:The Elec(韩国电子时报))
Amkor(安靠科技)已经是英特尔(Intel)在玻璃基板项目上的关键合作伙伴,多家主要公司已对这项将改变芯片制造业务基础的下一代技术表现出兴趣。英特尔(Intel)已经展示了其首款“玻璃核心”基板,该基板利用EMIB先进封装技术,为下一代人工智能产品提供动力。
玻璃基板项目是在英特尔(Intel)前任CEO帕特·基辛格(Pat Gelsinger)的领导下启动的。此前有报道称,英特尔(Intel)可能放弃该项目,但英特尔(Intel)现任CEO陈立武(Lip-Bu Tan)表示有兴趣继续推进。
从大局来看,三年的等待时间并不长。如果玻璃基板能够像宣传的那样发挥作用,那么英特尔(Intel)的代工业务有望成为人工智能领域领先的芯片制造中心之一。



